東京大ら、穴径6μm以下の微細な加工を実現:次世代半導体パッケージ基板向け
東京大学と味の素ファインテクノ、三菱電機、スペクトロニクスは、半導体パッケージ基板に穴径6μm以下の微細な加工を行うための技術を開発した。LSIのさらなる微細化や大規模なチップレット集積システムを支える技術として注目される。
毎秒数千穴の加工能力と、テーパー度75%の加工品質を達成
東京大学と味の素ファインテクノ、三菱電機、スペクトロニクスは2022年10月、半導体パッケージ基板に穴径6μm以下の微細な加工を行うための技術を開発したと発表した。高い加工品質と生産性を実現していて、LSIのさらなる微細化や大規模なチップレット集積システムを支える技術として注目される。
CPUなどの高性能半導体デバイスでは、パッケージ基板のビルドアップ材料として、味の素ファインテクノが製造販売する「味の素ビルドアップフィルム(ABF)」を用いるケースが多いという。このABFに多数の微細な穴を開け、銅めっきすることで電気的な配線を行っている。ところが、現行のレーザー加工技術では、穴径40μm程度が限界となっていた。
そこで今回、味の素ファインテクノやレーザー加工機を開発する三菱電機、深紫外短パルスレーザーを製造販売するスペクトロニクスは、東京大学が運用する産学官協創拠点「TACMIコンソーシアム」に、それぞれが強みとする技術を持ち寄り、10μm以下の穴径を加工できる技術の開発に取り組んだ。
実験に用いた次世代プロセス用開発機は、波長266nmでパルス幅がピコ秒というスペクトロニクス製の深紫外短パルスレーザーを、三菱電機がレーザー加工機に組み込んだ。さらに、東京大学が開発したレーザー加工プロセスのCPS(Cyber Physical System)化技術も活用しているという。
実験では、銅薄膜上に厚み5μmのABFを配置し、レーザー微細穴あけ加工を行った。この結果、穴径6μm以下を実現した。加工能力としては、1秒当たり数千穴という高い生産性を達成した。加工品質も高く、上面と下面の穴径比を定義するテーパー度は75%に達していることを確認した。
関連記事
 量子光のパルス波形を自在に制御する新手法を開発
量子光のパルス波形を自在に制御する新手法を開発
東京大学は、NTTや情報通信研究機構、理化学研究所の研究チームと共同で、量子光のパルス波形を自在に制御する新たな手法を開発した。量子光源となる「量子任意波形発生器」の核となる技術で、新手法を用い大規模光量子コンピュータの作動に必要となる特殊なパルス波形を持つ量子光の生成に成功した。 東京大学ら、熱伝導率が極めて高いCNF糸を開発
東京大学ら、熱伝導率が極めて高いCNF糸を開発
東京大学らによる研究グループは、熱伝導率が極めて高いCNF(セルロースナノファイバー)糸を開発した。試作したCNF糸の熱伝導性は、紙などの木質バイオマスに比べ100倍以上になり、放熱性能が求められるフレキシブルプリント基板などへの応用が期待されている。 可視・電波透過性が高い透明反射遮熱フィルム開発
可視・電波透過性が高い透明反射遮熱フィルム開発
東京大学は、省エネガラス窓に応用できるフレキシブルな「透明反射遮熱フィルム」を開発した。可視光や電波の透過性が高く、熱線を遮る能力にも優れている。5G(第5世代移動通信)で用いられるマイクロ波帯域の電波を遮ることも無いという。 東京大学ら、高品質の磁性vdWヘテロ構造を作製
東京大学ら、高品質の磁性vdWヘテロ構造を作製
東京大学らによる研究グループは、二次元金属のNbSe2薄膜と、二次元強磁性体のV5Se8薄膜を重ねた「磁性ファンデルワールス(vdW)ヘテロ構造」を作製することに成功した。ヘテロ構造の界面には「フェロバレー強磁性」という新たな状態が形成されていることも確認した。 東京大ら、ひずみで反強磁性体の磁気状態を制御
東京大ら、ひずみで反強磁性体の磁気状態を制御
東京大学は、ブリティッシュコロンビア大学などからなる国際共同研究グループと共同で、反強磁性体「Mn▽▽3▽▽Sn」の磁気状態を、結晶のひずみによって制御することに成功した。開発した制御技術を用いることで、MRAMのさらなる高速化と高密度化を実現することが可能になるという。 PSB技術を用いたチップレット集積技術を開発
PSB技術を用いたチップレット集積技術を開発
東京工業大学とアオイ電子らによる共同研究チームは、広帯域のチップ間接続性能と集積規模の拡大を可能にするチップレット集積技術「Pillar-Suspended Bridge(PSB)」を開発したと発表した。
Copyright © ITmedia, Inc. All Rights Reserved.
記事ランキング
- 2023年の世界半導体売上高ランキングトップ20、NVIDIAが初の2位に
- 中国政府の「Intel/AMD禁止令」、中国企業への強い追い風に
- JDI、次世代有機ELディスプレイ「eLEAP」を24年12月に量産開始へ
- 重量はクジラ級! 超巨大な高NA EUV装置の設置をIntelが公開
- 全固体ナトリウム電池の量産化に向けた新合成プロセスを開発、大阪公立大
- パワー半導体向けウエハー市場、2035年に1兆円台へ
- Intelが高NA EUV装置の組み立てを完了、Intel 14Aからの導入に向けて前進
- わずか3個のLSIでモバイル超音波診断装置を実現、ソシオネクスト
- 就業人員の4割が帰還組、ルネサス甲府工場が10年の時を経て再稼働
- TSMC、24年Q1は増収増益 地震の影響は「最小限にとどまる」

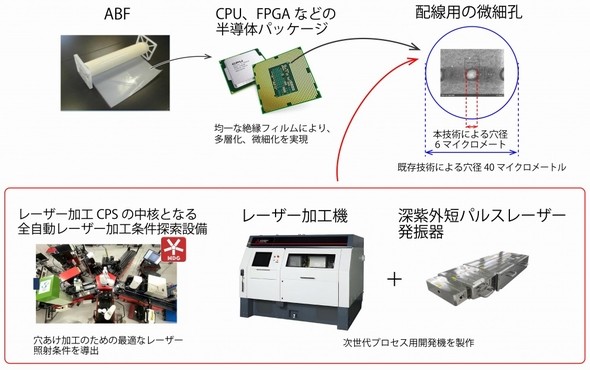 開発成果の概要 出所:東京大学他
開発成果の概要 出所:東京大学他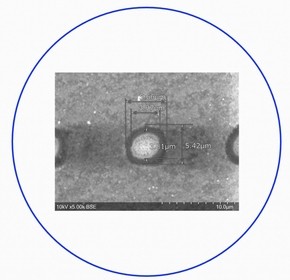
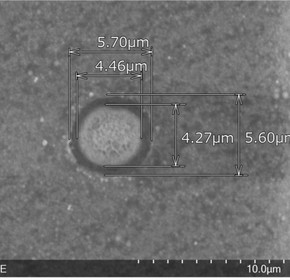 左はABFに穴径6μmの加工をした電子顕微鏡写真(青丸は40μmの穴サイズ相当)、右はテーパー度75%で穴あけをした例 出所:東京大学他
左はABFに穴径6μmの加工をした電子顕微鏡写真(青丸は40μmの穴サイズ相当)、右はテーパー度75%で穴あけをした例 出所:東京大学他