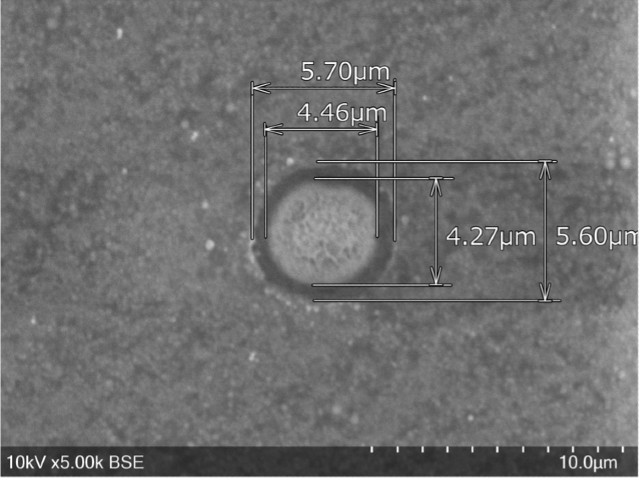 東京大学,味の素ファインテクノ,三菱電機,スペクトロニクスは,次世代の半導体製造工程に必要な,パッケージ基板への6μm以下という極微細レーザー穴あけ加工技術を開発した(ニュースリリース)。
東京大学,味の素ファインテクノ,三菱電機,スペクトロニクスは,次世代の半導体製造工程に必要な,パッケージ基板への6μm以下という極微細レーザー穴あけ加工技術を開発した(ニュースリリース)。
現在,CPUに代表される高度な半導体においては,パッケージ基板のビルドアップ材料として「味の素ビルドアップフィルム」(ABF)が広く用いられており,ABFに対してレーザーを用いて多数の微細な穴あけ加工をして,銅めっきすることによって電気的な微細配線をしている。
現在用いられている穴径は40μm程度であり,加工に用いるレーザーの波長が長いために,これ以上の微細穴あけは困難だった。極端紫外光(EUV)リソグラフィ技術の進展により,半導体の微細化や半導体構造のチップレット化など半導体を取り巻く環境が大きく変化する現在,ABFの微細穴あけに要求される穴径はより一層の微細化が求められている。
今回,研究グループは,次世代半導体製造に資する10μm以下の穴径の微細穴を,製造のニーズを満たす品質で,製造ラインの生産能力も視野に入れて実現することを目指した。銅薄膜上に厚さ5μmのABFを配置して,これにレーザー微細穴あけ加工を実施した。
レーザーにはスペクトロニクスが開発・販売している波長266nmでピコ秒のパルス幅の深紫外レーザーを用い,レーザー加工機には三菱電機が深紫外短パルスレーザーを組み込んだ,次世代プロセス用開発機を用いた。
東京大学がSIP事業で開発する,加工プロセスを最適化するCPS型レーザー加工機システムの成果も取り入れた結果,6μm以下の極微細穴あけ加工を実現した。この微細穴は穴径が6μm以下であるとともに,加工能力については,1秒当たり数千穴を実現している。
また,高品位加工用のパラメータを用いることで,6μmの直径において,上面の穴径と下面の穴径の比として定義されるテーパー度は品質基準値の75%に達することがわかった。これらは,次世代の半導体製造におけるパッケージ基板に対する基本的な要求に応えたものだとする。
この開発は,レーザー加工のスマート化を目指す産学官協創の拠点として東京大学が運用する「TACMIコンソーシアム」において実証を進めている。この技術は,微細化・複雑化が進む次世代半導体製造において,チップレット技術,マルチスケールデバイス化などを支える後工程に必要とされている技術であり,研究グループは,ますます高度化の需要が高まる先端半導体製造での活用が期待されるとしている。